成果简介:中国科学院合肥物质院智能所仿生智能技术中心科研团队率先在国内开展面向三维先进封装的TGV工艺研究,开发了基于导电硅和金属的两款TGV晶圆(Through Glass Via, TGV)。开发出了高均一性、高致密、高深宽比的TGV晶圆,具有超低漏率、超低信号损耗的优势,满足环形谐振器、波导缝隙天线、毫米波天线等5G/6G高频芯片,以及新型MEMS陀螺仪、加速度计3D晶圆及封装需求。
市场前景:随着5G、人工智能和高效能运算等新技术兴起,半导体芯片对于高性能、小尺寸、高可靠性以及超低功耗的要求越来越高,这也促使先进封装技术不断突破发展,先进三维封装技术也逐渐成为实现电子产品小型化、轻质化、多功能化的重要手段。玻璃穿孔(TGV)是实现玻璃正反面垂直导电的一种新型工艺,具有绝缘性高、气密性高、适合跨尺度多区高精度集成等优点,在射频器件、微机电系统(MEMS)封装、微器件系统集成等领域具有广泛的应用前景。根据MEMS市场咨询机构Yole的数据,全球封测行业市场规模保持平稳增长,预计从2019年的680亿美元增长到2025年的850亿美元,年均复合增速约4%。根据中国半导体行业协会的数据,中国封测行业市场规模从2011年的976亿元增长到了2019年的2350亿元,年均复合增速约11.6%。5G/6G射频芯片市场规模在2023年将达到50亿元。高端芯片微流控市场在2026年将达到200亿每年。应用领域广,市场前景大。
相关图片:
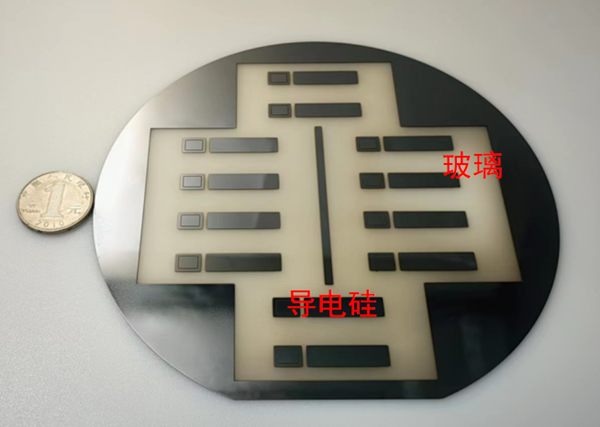
1、高掺杂硅为导电材料的TGV,可以用于阳极键合实现低漏率高真空芯片封装

2、金属浆料为导电材料的TGV,可以用于高频低传输损耗芯片封装